반도체 공정2: ALD
이 글은 sk하이포 교육 이수 후 복습하기 위한 차원으로 작성한 글입니다.
배워가는 입장이기 때문에 오류가 있을 수 있습니다! 오류 지적 대환영
* Atomic Layer Deposition (ALD)
박막을 만들 때 CVD, PVD를 사용하는데, 소자 미세화로 capacitor나 gate oxide가 얇아지면서 CVD, PVD 사용에 한계가 생겼다. 따라서 원자층을 한층 한층 쌓아 올려 막을 형성하는 ALD 적층 방식을 사용하게 된다.

* 진행과정



ALD는 SLG 방법으로 증착하는 방법!
* ALD 장점
- conformality(=step coverage)가 좋다
- 원자 단위로 두께를 쉽게 조절할 수 있다
- 원자 레벨의 조성비 조절
- 넓은 면적의 uniformity (균일) → SLG 방법으로 증착하여 전지역의 두께가 같다
- impurity(불순물)가 CVD에 비해 적다
- 성장 온도가 CVD에 비해 낮다
* ALD Process Characteristics
+ 참고자료
https://news.skhynix.co.kr/post/as-ald-technology
나노 스케일의 더 작은 반도체 소자 제작을 위한 AS-ALD 기술
반도체 소자의 미세화로 트랜지스터 밀도는 크게 증가하게 되었고, 이를 통해 컴퓨터에서부터 스마트폰에 이르기까지 다양한 IT 제품의 성능을 향상시켜왔다. 이렇게 진화되는 미세화 과정에서
news.skhynix.co.kr
ALD 공정에서 물을 사용하여 증착된 알루미늄 산화물(Al₂O₃, 또는 알루미나)은 주어진 공정 온도에서 Al Precursor와 기질에 따라 핵 생성 및 성장 특성이 달라진다.

위의 Al precursor 비교를 보면, 표면 반응성 및 피복률(Surface Lewis Acidity and Coverage rate)은 특정 precursor 및 루이스 산과 염기(Lewis Acids and Bases)의 반응 크기에 따라 결정된다. → ALD 공정에 적합한 Precursor를 선택하는 것이 아주 중요
- 루이스 산과 염기 : 루이스 산-염기 반응론에 의하면 루이스 산은 전자쌍 수용체이고 루이스 염기는 전자쌍 기증체이다. 따라서 루이스 염기는 루이스 산에 전자 쌍을 기증하여 공유 결합을 갖는 생성물을 만들 수 있다.
- 표면 피복률 : 성질이 서로 다른 두 물질이 맞닿는 경계면의 분자 간 발생되는 상호작용으로 인해 증착되는 비율
* 온도의 영향
ALD는 반응하기 위해 에너지가 필요하다.

Condensation : 웨이퍼의 온도가 낮을 때 (분자는 뜨겁고, 웨이퍼는 차가운 경우)
Decomposition : 열분해의 Chemical rxn으로 떡이지게 된 경우
Small Thermal energy : 반응Energy보다 낮은 에너지를 가해 반응이 일어나지 않은 경우
Desorption : 어떤 precursor인지에 따라 다름
ALD Window : 온도에 크게 영향을 받지 않는 구간
* PVD, CVD, ALD 비교
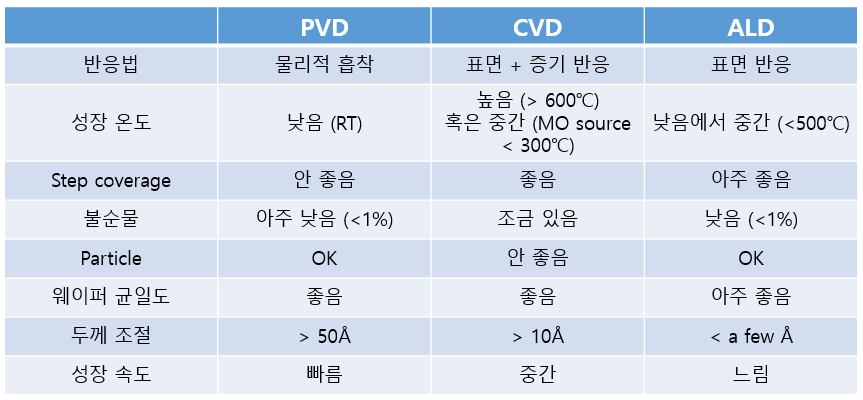
* Plasma Enhanced ALD (PE-ALD)
: Plasma가 인가된 ALD

- 높은 반응성
→ 높은 성장율
→ 낮은 증착 온도
→ 필름 속성이 좋음
- 표면에 플라즈마 노출
→ 표면의 핵 형성 및 접착력 향상 (반응성이 낮은 precursor들도 반응됨)
* PE-ALD : Pros and Cons

